
Глава 3. Неравновесные процессы в полупроводниках
§ 12. Генерация и рекомбинация неравновесных носителей заряда
Генерация свободных носителей. Мы видели, что при температуре, отличной от абсолютного нуля, любой полупроводник характеризуется некоторой концентрацией свободных носителей. Чем выше температура, тем, вообще говоря, выше концентрация свободных носителей. Появление свободных носителей объясняется переходом электронов из валентной зоны или с донорных уровней в зону проводимости. Этот процесс называется генерацией свободных носителей (рис. 31).
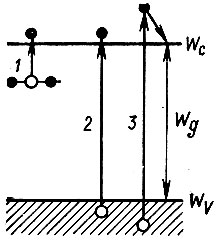
Рис. 31
Рекомбинация свободных носителей. Однако если бы процесс генерации был единственным в полупроводнике, то к уже перешедшим в зону проводимости электронам присоединялись бы все новые и новые и через некоторое время в зоне проводимости оказались бы все валентные электроны. Экспериментально такая картина не наблюдается. Объясняется это тем, что наряду с процессом генерации одновременно происходит процесс рекомбинации свободных носителей. По истечении некоторого промежутка времени электроны из зоны проводимости возвращаются в валентную зону или на пустые места какого-либо примесного уровня (рис. 32). Иначе говоря, свободный электрон, пропутешествовав в межатомном пространстве кристалла, рано или поздно встречается с вакантным местом и занимает его. При этом если это вакантное место - положительно заряженный ион примеси, то происходит исчезновение одного электрона проводимости, а если вакантным местом является разорванная связь в кристаллической решетке - дырка, то происходит исчезновение сразу двух свободных носителей: и электрона, и дырки.

Рис. 32
Равновесные носители. Концентрация свободных носителей в полупроводнике определяется одновременно протекающими встречными процессами - генерацией и рекомбинацией. Тепловые процессы в твердых телах всегда инерционны, то есть протекают достаточно медленно, поэтому практически при любой температуре процессы тепловой генерации и рекомбинации успевают прийти в равновесие. Благодаря этому и концентрация носителей, определяемая только тепловыми процессами, называется равновесной, а сами носители - равновесными. Поскольку для равновесных носителей процессы генерации и рекомбинации всегда оказываются уравновешенными (взамен каждой рекомбинирующей пары вследствие термического возбуждения тут же создается новая пара носителей заряда), то обычно сами процессы генерации и рекомбинации в условиях теплового равновесия не принимаются во внимание.
Неравновесные носители. Наряду с тепловым возбуждением могут действовать и другие факторы, создающие свободные носители в полупроводниках, например облучение светом, бомбардировка различными частицами, вызывающими ионизацию, и т. д. Свободные носители могут также проникать через контакт из другого тела. Свободные носители, появляющиеся в полупроводнике, благодаря этим факторам являются избыточными по отношению к равновесным и называются неравновесными носителями.
Механизм возникновения неравновесных носителей принципиально отличается от механизма образования равновесных носителей. При тепловой генерации подводимое извне тепло определяет увеличение энергии тепловых колебаний атомов в решетке кристалла, и когда энергии этих колебаний оказывается достаточно для разрыва связей валентных электронов, происходит ионизация атомов, сопровождающаяся образованием равновесных носителей. Таким образом, подводимое тепло создает свободные носители, действуя через посредника - кристаллическую решетку полупроводника. Благодаря этому концентрация равновесных носителей оказывается одинаковой во всем объеме полупроводника.
При создании же неравновесных носителей энергия внешнего источника возбуждения (энергия фотонов света, энергия бомбардирующих электронов или других частиц) передается непосредственно валентным электронам, в то время как энергия кристаллической решетки сохраняется практически неизменной. Поэтому, во-первых, неравновесные носители при их возникновении не находятся в тепловом равновесии с кристаллом и, во-вторых, распределение их плотности по объему может быть очень неравномерным - концентрация неравновесных носителей обычно уменьшается по мере удаления от поверхности кристалла или от освещенного места.
Непосредственная передача энергии носителю заряда часто приводит к тому, что электрон, например, приобретает энергию большую, чем необходимо для возможности преодоления им запрещенной зоны. В этом случае избыточные электроны забрасываются в зону проводимости на высокие энергетические уровни (переход 3 на рисунке 31), причем кинетическая энергия таких неравновесных носителей оказывается значительно больше средней энергии  которой обладают располагающиеся у дна зоны проводимости тепловые равновесные электроны. В дальнейшем эта избыточная кинетическая энергия быстро рассеивается в процессе столкновений неравновесных электронов с дефектами кристаллической решетки. За время 10-10 с быстрые электроны претерпевают около тысячи актов рассеяния, в результате чего их кинетическая энергия становится одинаковой с энергией тепловых электронов. Можно считать, что кинетическая энергия неравновесных носителей практически сразу после их возникновения становится сравнимой с энергией равновесных носителей, благодаря чему их подвижность имеет то же значение, что и подвижность равновесных носителей. Поэтому изменение проводимости при образовании неравновесных носителей обусловлено лишь изменением суммарной концентрации носителей; мгновенные отличия энергии и подвижности неравновесных носителей, имеющиеся непосредственно после их создания, не играют роли.
которой обладают располагающиеся у дна зоны проводимости тепловые равновесные электроны. В дальнейшем эта избыточная кинетическая энергия быстро рассеивается в процессе столкновений неравновесных электронов с дефектами кристаллической решетки. За время 10-10 с быстрые электроны претерпевают около тысячи актов рассеяния, в результате чего их кинетическая энергия становится одинаковой с энергией тепловых электронов. Можно считать, что кинетическая энергия неравновесных носителей практически сразу после их возникновения становится сравнимой с энергией равновесных носителей, благодаря чему их подвижность имеет то же значение, что и подвижность равновесных носителей. Поэтому изменение проводимости при образовании неравновесных носителей обусловлено лишь изменением суммарной концентрации носителей; мгновенные отличия энергии и подвижности неравновесных носителей, имеющиеся непосредственно после их создания, не играют роли.
Условие электронейтральности. Обозначив через Δn и Δр концентрации избыточных электронов и дырок, можно записать полные концентрации носителей так:

где n0 и р0 - соответственно равновесные концентрации электронов и дырок. Если при внешнем воздействии на полупроводник создавались только собственные носители заряда (возбуждались переходы электронов из валентной зоны в зону проводимости), а сам полупроводник не содержит какого-либо объемного заряда, то концентрация неравновесных электронов должна быть равна концентрации избыточных дырок:

Это - условие электронейтральности.
Так как подвижность избыточных носителей, как мы уже отмечали, практически не отличается от подвижности равновесных носителей, то для дополнительной электропроводности Δσ, возникающей в полупроводнике под воздействием внешнего возбуждающего источника, можно записать выражение

а для полной электропроводности - выражение

После выключения возбуждающего источника полупроводник постепенно возвращается в состояние равновесия. При этом концентрация свободных носителей в нем вновь становится равновесной. Восстановление равновесия происходит благодаря процессу рекомбинации. Однако до акта рекомбинации (до встречи электрона с дыркой) каждый носитель некоторое время находится в свободном состоянии. Это время зависит от многих причин и колеблется в широких пределах - от 102 до 10-9 с. Поэтому для характеристики коллектива неравновесных носителей в целом вводят так называемое среднее время жизни: для неравновесных электронов τn и для дырок τp. Практически среднее время жизни, например, электрона определяется как средний отрезок времени между моментом генерации избыточного электрона и моментом захвата его дыркой.
Скорость рекомбинации. С понятием среднего времени жизни связано понятие скорости рекомбинации (скорости изменения концентрации избыточных носителей). За скорость рекомбинации принимают число рекомбинирующих пар носителей в единицу времени Δn/τn (где Δn - концентрация неравновесных носителей в данный момент времени t). Понятно, что скорость рекомбинации тем больше, чем больше концентрация неравновесных носителей. Со временем скорость рекомбинации уменьшается, так как благодаря процессу рекомбинации число избыточных носителей падает.
Простой расчет показывает, что убывание концентрации неравновесных носителей со временем происходит по экспоненциальному закону:

где Δn0 - начальная концентрация избыточных носителей в момент времени t = 0 (момент выключения возбуждающего источника),  - основание натурального логарифма.
- основание натурального логарифма.
Из этой формулы следует, что по истечении времени τn после выключения возбуждающего источника концентрация неравновесных носителей уменьшится в е раз. Действительно, при  концентрация Δn становится равной
концентрация Δn становится равной  График зависимости
График зависимости  приведен на рисунке 33. По этому графику можно практически определить величину τn как отрезок, отсекаемый на оси времени касательной к кривой в точке t = 0.
приведен на рисунке 33. По этому графику можно практически определить величину τn как отрезок, отсекаемый на оси времени касательной к кривой в точке t = 0.
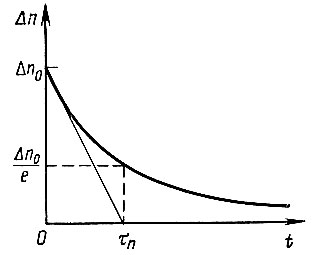
Рис. 33
Понятие сечения захвата. Процесс рекомбинации предполагает захват электрона дыркой. Способность дырки совершать захват электрона характеризуется так называемым сечением захвата. Проведем через дырку плоскость, перпендикулярную направлению движения электрона, приближающегося к дырке. Если электрон, пересекая эту плоскость, пролетает мимо дырки на большом расстоянии, то он не будет захвачен, а лишь в большей или меньшей мере изменит направление своего движения. Но если электрон пересекает эту плоскость на малом расстоянии от дырки, т. е. внутри круга достаточно малого радиуса, то он оказывается захваченным ею. Площадь этого круга и называется эффективным сечением захвата или просто сечением захвата. Сечение захвата сильно зависит от скорости электрона относительно дырки и природы этой дырки.
Пути рекомбинации. Различают два случая рекомбинации носителей заряда. В одном случае электрон совершает прямой переход из зоны проводимости в валентную зону (переход 1 на рисунке 32). Это так называемая межзонная рекомбинация. В другом случае переход электрона из зоны проводимости в валентную зону происходит в два этапа: сначала электрон из зоны проводимости переходит на некоторый промежуточный уровень (переход 2), созданный в кристалле каким-либо примесным атомом, а потом он с этого уровня переходит на свободное место в валентную зону (переход 2'). Такой процесс называется рекомбинацией через примесные центры. В обоих случаях переход электрона из зоны проводимости в валентную зону сопровождается выделением энергии, приблизительно равной ширине запрещенной зоны Wg (как правило, в рекомбинации участвуют электроны, находящиеся у дна зоны проводимости, и дырки, расположенные у потолка валентной зоны).
Освобождающаяся при рекомбинации энергия может выделиться в виде кванта излучения либо перейти в энергию кристаллической решетки. В соответствии с этим говорят об излучательной и безызлучательной рекомбинации.
Излучательная рекомбинация. При излучательной рекомбинации энергия электрона, объединяющегося с дыркой, преобразуется в энергию фотона hv. В этом случае акт рекомбинации подобен возвращению возбужденного атома в основное состояние (электрон с возбужденной орбиты переходит на основную орбиту). Энергия фотона, испускаемого при межзонной рекомбинации, согласно закону сохранения энергии равна

где  - энергия электрона до рекомбинации (у дна зоны проводимости), а
- энергия электрона до рекомбинации (у дна зоны проводимости), а  - энергия электрона после рекомбинации (у потолка валентной зоны).
- энергия электрона после рекомбинации (у потолка валентной зоны).
Излучательная рекомбинация в большинстве случаев связана с прямыми межзонными переходами электронов. Однако такие переходы в полупроводниках имеют место лишь в хорошо очищенных кристаллах с узкой запрещенной зоной, например в кристаллах антимонида индия (InSb), у которых ширина запрещенной зоны Wg равна всего 0,18 эВ. Время жизни электрона в этих кристаллах по отношению к излучательной рекомбинации мало (порядка 10-7 с). Поэтому практически все электроны рекомбинируют с испусканием фотона.
По мере увеличения ширины запрещенной зоны вероятность излучательной рекомбинации становится все меньше. Например, в собственном германии, для которого при комнатной температуре  время жизни электрона по отношению к излучательной рекомбинации составляет 1 с, в то время как по отношению к безызлучательной рекомбинации время жизни по порядку величины равно 10-3-10-4 с. Это означает, что на несколько тысяч безызлучательных рекомбинационных переходов приходится всего один акт рекомбинации с испусканием фотона.
время жизни электрона по отношению к излучательной рекомбинации составляет 1 с, в то время как по отношению к безызлучательной рекомбинации время жизни по порядку величины равно 10-3-10-4 с. Это означает, что на несколько тысяч безызлучательных рекомбинационных переходов приходится всего один акт рекомбинации с испусканием фотона.
Безызлучательная рекомбинация. Безызлучательная рекомбинация, характерная для полупроводников с достаточно широкой запрещенной зоной, протекает, как правило, с участием примесных центров. Объясняется это тем, что высвобождающаяся при переходе электрона из зоны проводимости в валентную зону довольно большая энергия не может быть передана кристаллической решетке за один раз. Вероятность такого акта столь же. мала, как, например, вероятность одновременного столкновения в одной точке сразу десяти частиц. В случае же рекомбинации через примесные уровни энергия электрона передается кристаллической решетке в два этапа. При этом чем ближе к середине запрещенной зоны находится энергетический уровень примесного атома, тем более вероятной оказывается рекомбинация через него, потому что энергия в этом случае выделяется в виде двух приблизительно одинаковых порций, каждая из которых равна приблизительно половине Wg. На языке зонной теории это означает, что на первом этапе примесный центр захватывает электрон, а на втором - дырку. В принципе этапы этого процесса могут происходить и в обратном порядке. Их последовательность определяется вероятностью захвата примесным центром электрона и дырки. Если энергетический уровень примесного центра расположен ближе к дну зоны проводимости, то вероятность захвата электрона будет выше вероятности захвата дырки, так как при захвате электрона будет выделяться меньшая энергия (вообще, чем меньше выделяемая энергия, тем процесс более вероятен). В этом случае электрону после его захвата примесным центром приходится некоторое время "ждать" дырку. Дело в том, что хотя дырок может быть и много, не с каждой из них может прорекомбинировать электрон. Рекомбинация возможна лишь в тех случаях, когда электрон имеет возможность отдать выделяемую энергию кристаллической решетке.
Центры захвата и центры прилипания. Может случиться так, что процесс рекомбинации избыточных носителей уже закончился, а электрон, находясь на примесном центре, так и не дождался нужной дырки. Обычно такая ситуация бывает, когда уровень примесного центра находится достаточно далеко от середины запрещенной зоны (переход 3 на рисунке 32). В этом случае примесный центр называется центром захвата электрона.
Если уровень примесного центра расположен недалеко от дна зоны проводимости, так что энергетическое расстояние Wc-Wnp оказывается сравнимым с энергией тепловых колебаний решетки, то электрон, попавший в такой центр, может быть снова заброшен в зону проводимости (случай 4 на рисунке 32). Этот процесс может повториться многократно, прежде чем электрон "свалится" в валентную зону. Такие примесные центры называются Центрами прилипания. Наличие центров прилипания может существенно увеличить среднее время жизни неравновесных носителей.
В высокочастотных полупроводниковых приборах необходимо, чтобы избыточные носители быстро исчезали после выключения возбуждающего сигнала. Именно поэтому в таких приборах, создаваемых на основе моноатомных кристаллов кремния или германия, для получения большой скорости рекомбинации используются примеси золота, никеля, меди и некоторых других элементов, которые создают рекомбинационные уровни вблизи середины запрещенной зоны.
Поверхностная рекомбинация. Исчезновение свободных носителей может происходить не только в результате объемной рекомбинации, но и вследствие поверхностной рекомбинации, которая в большинстве случаев протекает гораздо более интенсивно, чем объемная. Объясняется это тем, что на поверхности полупроводника всегда имеется большое количество адсорбированных примесных атомов и различных дефектов, являющихся эффективными центрами рекомбинации. Особенно значительна роль поверхностной рекомбинации в случае тонких образцов, когда объем мал, а поверхность относительно велика.
Поскольку рекомбинация на поверхности протекает всегда более интенсивно, чем в объеме, то вблизи поверхности число свободных носителей оказывается меньшим, чем в глубине полупроводника. Образующийся перепад концентрации вызывает поток свободных носителей изнутри полупроводника к поверхности. Чем больше разность концентраций (то есть чем интенсивнее протекает рекомбинация носителей на поверхности), тем с большей скоростью движутся носители к границе полупроводника. Для уменьшения интенсивности процесса поверхностной рекомбинации образцы полупроводника подвергаются специальной обработке (химическому травлению, тщательной отмывке и т. п.), обеспечивающей удаление с поверхности рекомбинационных центров. При хорошей обработке поверхности удается снизить скорость процесса поверхностной рекомбинации в сотни раз.
|
ПОИСК:
|