
§ 22. Электронно-дырочный переход
В подавляющем большинстве полупроводниковых устройств, используемых в настоящее время в технике, главной частью является контакт двух примесных полупроводников, обладающих различным типом проводимости, так называемый электронно-дырочный переход или p-n-переход.
Способы получения p-n-переходов. Контакт между электронным и дырочным полупроводниками можно получить и путем прямого тесного соединения двух образцов, имеющих различные типы проводимости. Однако использовать такой контакт для создания прибора практически невозможно, так как наличие различных дефектов и примесей, и в первую очередь окисной пленки, всегда присутствующей на поверхности полупроводника, вносит резкие изменения в свойства границы раздела полупроводников. Поэтому для получения p-n-перехода с хорошо контролируемыми и постоянными свойствами необходимо создать его в виде внутренней границы раздела, на которой полупроводник одного типа переходил бы непрерывно в полупроводник другого типа. Методов изготовления p-n-переходов в настоящее время довольно много, но мы ограничимся рассмотрением только двух из них: метода оплавления и метода диффузии.
При использовании метода вплавления на пластину из полупроводника n-типа кладут небольшой кусочек какого-либо трехвалентного металла, например индия (рис. 62, а), а затем помещают в печь, где в атмосфере инертного газа нагревают до температуры 550-600°С. Индий при этой температуре плавится, и образующаяся капелька растворяет в себе германий (рис. 62, б). Спустя некоторое время печь выключают, и при охлаждении из расплава начинает выпадать германий, содержащий примесные атомы индия. Если охлаждение происходит достаточно медленно, то выпадающий германий кристаллизуется в виде монокристалла, ориентация которого в точности совпадает с ориентацией монокристалла подложки. Однако в отличие от подложки, имеющей проводимость n-типа, вновь создаваемая область германия обладает проводимостью p-типа, и поэтому на границе раздела нерастворившейся части подложки и выкристаллизовавшегося из расплава участка образуется p-n-переход (рис. 62, в). Вплавной p-n-переход характеризуется почти скачкообразным изменением типа проводимости от электронной к дырочной и поэтому называется резким p-n-переходом.
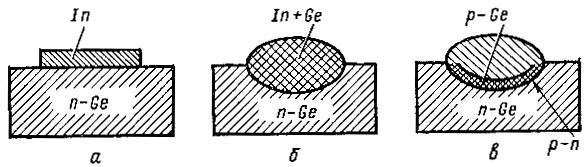
Рис. 62
В противоположность к вплавному диффузионный переход отличается постепенным изменением типа проводимости от n-типа к p-типу, и поэтому его называют плавным p-n-переходом. Такой электроннодырочный переход образуется в результате диффузии акцепторной примеси из газообразной или жидкой фазы в донорный полупроводник или донорной примеси в акцепторный полупроводник. Если в качестве подложки используется донорный полупроводник, то акцепторные атомы, проникая в процессе диффузии в глубь образца, сначала превращают его в компенсированный полупроводник (то есть нейтрализуют донорные примеси и придают образцу свойства собственного полупроводника), а затем по мере накопления примесных атомов - в дырочный. Степень легированности образующегося p-полупроводника, а также глубина проникновения акцепторных атомов в объем подложки определяются температурой и длительностью процесса диффузии. Граница, разделяющая преобразованную в p-область часть полупроводника от незатронутой диффузией подложки n-типа, как раз и представляет собой p-n-переход (рис. 63). Вполне естественно, что в данном случае граница раздела между акцепторным и донорным полупроводниками, представляющими фактически различные части одного и того же образца, не может быть резкой: изменение типа проводимости в диффузионных p-n-переходах происходит постепенно.

Рис. 63
Различают симметричные и несимметричные p-n-переходы. Если концентрации легирующих примесей по разные стороны перехода одинаковы или достаточно близки друг к другу, то говорят о симметричном p-n-переходе. Если же концентрация одной из примесей, например донорной, много больше концентрации примеси по другую сторону p-n-перехода  то переход называется несимметричным. В технике в большинстве случаев используются несимметричные p-n-переходы. Но мы для простоты ограничимся рассмотрением симметричного электронно-дырочного перехода, считая ND = NA.
то переход называется несимметричным. В технике в большинстве случаев используются несимметричные p-n-переходы. Но мы для простоты ограничимся рассмотрением симметричного электронно-дырочного перехода, считая ND = NA.
Электронно-дырочный переход в состоянии равновесия. Рассмотрим резкий p-n-переход с симметричным распределением примесей по обе стороны от границы раздела. Пусть слева от границы (рис. 64, а) в электронном полупроводнике концентрация донорной примеси скачкообразно падает от значения ND до 0, а справа в дырочном полупроводнике концентрация акцепторной примеси возрастает также скачкообразно от 0 до NA. Основными носителями в полупроводнике n-типа являются электроны, а в полупроводнике p-типа - дырки. Появление большого количества основных носителей в соответствующих областях объясняется тепловым возбуждением и ионизацией донорных и акцепторных центров. При достаточно высокой (например, при комнатной) температуре практически все донорные и акцепторные примесные атомы оказываются ионизированными. Поэтому вдали от границы раздела полупроводников концентрацию электронов в полупроводнике n-типа можно считать равной концентрации донорной примеси (nn0 = ND), а концентрацию дырок в полупроводнике p-типа - равной концентрации акцепторных центров (рр0 = NA). Индекс 0 указывает на то, что соответствующая концентрация относится к состоянию равновесия.
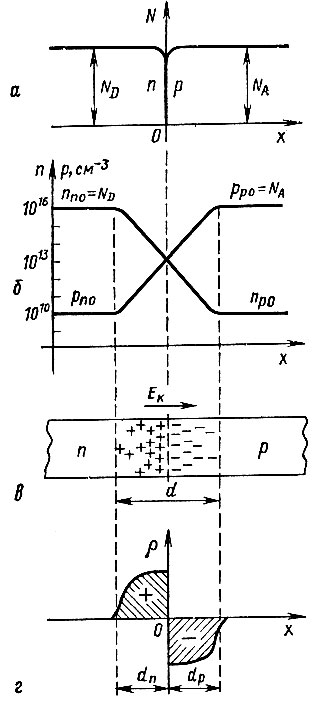
Рис. 64
В каждой из контактирующих областей наряду с основными носителями имеется и определенное количество неосновных носителей: в n-области имеются дырки, а в p-области - электроны. Их концентрацию можно определить, используя закон действующих масс (см. § 10). Допустим, что концентрация примесей в каждой из областей равна 1016 см-3. Такой же будет и концентрация основных носителей:

Если считать, что при комнатной температуре концентрация носителей в собственном полупроводнике ni = 1013 см-3, то для концентраций неосновных носителей, например электронов в дырочном полупроводнике, получим:

Точно таким же будет и количество дырок в электронном полупроводнике. Таким образом, мы видим, что при переходе через границу раздела концентрации носителей одного типа (электронов или дырок) изменяются в 106 раз. Изменение концентрации носителей вблизи границы происходит однако не столь резко, как изменение концентрации атомов легирующих примесей, так как примесные атомы входят в состав кристаллической решетки и жестко связаны с ней, в то время как носители являются свободными и могут перемещаться по кристаллу. Изменение концентраций носителей в области контакта графически показано на рисунке 64, б.
Однако, каким бы плавным ни было изменение концентрации, полный перепад оказывается очень большим. Это приводит к довольно интенсивной диффузии основных носителей через p-n-переход: из n-области в p-область диффундируют электроны, а навстречу им - дырки. Результатом процесса диффузии является возникновение диффузионного тока через p-n-переход и контактной разности потенциалов.
Диффузионный ток. Электроны, приходящие в p-область, богатую дырками, довольно быстро рекомбинируют, поэтому концентрация их в этой области практически не повышается и остается на уровне равновесной. В то же время в n-области вместо ушедших электронов благодаря непрерывной тепловой генерации появляются новые электроны. Таким образом, несмотря на диффузию электронов из n-области в p-область, различие их концентрации в этих областях остается неизменным. Поэтому неизменной остается и скорость диффузии электронов. То же относится и к процессу диффузии дырок из p-области в n-область. Такой установившийся направленный перенос носителей заряда, естественно, приводит к возникновению через p-n-переход тока, который называется диффузионным током. Подчеркнем, что диффузионный ток, создаваемый переходом дырок, складывается с диффузионным током, создаваемым встречным потоком электронов.
Контактная разность потенциалов. Ток проводимости. Приход в приконтактную область электронного полупроводника дырок из p-полупроводника и, что более существенно, уход из этой области большого числа электронов, оставляющих нескомпенсированными положительно заряженные неподвижные ионы донорной примеси, приводят к появлению у границы раздела в n-полупроводнике положительного заряда (рис. 64, в). Аналогично этому уход дырок из приконтактной области p-полупроводника, а также приход электронов из n-полупроводника создают у границы раздела в p-полупроводнике отрицательно заряженную область. Протяженность этих областей в n- и p-полупроводниках обозначим соответственно через dn и dp. Распределение плотности заряда в приграничных областях показано на рисунке 64, г. Между разноименно заряженными областями образуется контактная разность потенциалов Uk и электрическое поле, которое препятствует дальнейшему диффузионному перетеканию основных носителей. Вместе с тем это поле не только не препятствует, но и, наоборот, способствует переходу через границу раздела неосновных носителей. Действительно, электроны, подходящие к p-n-переходу из глубины p-полупроводника, и дырки, приходящие из глубины n-полупроводника, подхватываются контактным полем и выводятся соответственно в n-область и p-область. Таким образом, в противовес диффузионному току, возникающему за счет перехода через границу раздела основных носителей, возникает встречный ток, определяемый переходом через ту же границу неосновных носителей в противоположном направлении. Ток этот получил название тока проводимости. Сила тока проводимости практически не зависит от значения контактной разности потенциалов, а определяется лишь процессом тепловой генерации неосновных носителей и условиями перехода их из объема полупроводника к границе раздела.
Зонная структура р-n-перехода в состоянии равновесия. Зонные диаграммы n- и p-полупроводников до начала перехода носителей через границу приведены на рисунке 65, а. Уровни электронов в вакууме, оба дна зон проводимости и потолки валентных зон расположены на одной высоте, а уровень Ферми при комнатной температуре находится в n-области вблизи дна зоны проводимости, в p-области у вершины валентной зоны. Диффузионное перетекание основных носителей, приводящее к оголению ионизированных донорных и акцепторных атомов и к появлению нескомпенсированных зарядов в приконтактных областях, вызывает смещение энергетических уровней. В n-области, заряжающейся положительно, все уровни смещаются вниз, а в p-области, заряжающейся отрицательно, - вверх. Перемещение уровней происходит до тех пор, пока, как уже было выяснено ранее, уровни Ферми не расположатся на одной высоте (рис. 65, б), что как раз и соответствует установлению состояния равновесия. Вследствие образования объемных разноименных электрических зарядов в приграничных областях по обе стороны от границы раздела изменятся соответственно потенциалы полупроводников и на участке p-n-перехода произойдет изгиб энергетических зон. Поскольку в глубинных областях полупроводников, достаточно удаленных от границы перехода, уровни Ферми сохраняют свое положение относительно остальных энергетических уровней, то изгиб энергетических зон приводит в возникновению потенциального барьера  Как видно из рисунка,
Как видно из рисунка,

или (что то же самое)


Рис. 65
Мы уже знаем, что положение уровня Ферми зависит от степени легированности полупроводника: чем сильнее легирован полупроводник, тем ближе к соответствующей разрешенной зоне располагается уровень Ферми. Например, чем больше донорной примеси введено в полупроводник, тем ближе к дну зоны проводимости разместится уровень Ферми. В предельном случае в невырожденных полупроводниках уровень Ферми в донорной области подходит вплотную к дну зоны проводимости, а в дырочной - к потолку валентной зоны. Таким образом, максимальное значение потенциального барьера φ0, max на границе двух невырожденных разнотипных полупроводников равно ширине запрещенной зоны Wg. В реальных же случаях φ0 для p-n-перехода между невырожденными полупроводниками обычно меньше Wg. Например, для рассматриваемого нами германиевого p-n-перехода с ND = NA = 1016 см-3 потенциальный барьер φ0 имеет при комнатной температуре значение около 0,35 эВ, что приблизительно составляет половину ширины запрещенной зоны.
Контактное электрическое поле является своеобразным регулятором перехода носителей через p-n-переход. Далеко не все электроны, идущие из n-области в p-область, могут преодолеть потенциальный барьер φ0. Так, электрон, обозначенный на рисунке цифрой 1, может за счет своей избыточной кинетической энергии преодолеть только часть потенциального барьера. Дойдя до точки М, он растрачивает всю свою кинетическую энергию на совершение работы против сил контактного поля и останавливается, после чего он выводится этим полем обратно в объем n-полупроводника. Аналогичная ситуация имеет место в случае дырки, идущей из р-области и обозначенной цифрой 1'. Преодолеть потенциальный барьер могут лишь те основные носители, энергия которых больше φ0. Такая возможность представляется, например, электрону 2 и дырке 2'. Но высокоэнергетических электронов и дырок мало, так как основная часть электронов находится вблизи дна зоны проводимости, а основная часть дырок - вблизи потолка валентной зоны. Поэтому потоки основных носителей через область p-n-перехода невелики, хотя общее число этих носителей огромно.
По отношению к неосновным носителям действие контактного поля оказывается противоположным. Это видно и из рисунка 65, б. Электрон 3 и дырка 3', подходящие к р-n-переходу, подхватываются контактным полем и выводятся на противоположную сторону перехода. При этом их кинетическая энергия увеличивается за счет работы сил поля. Однако, несмотря на благоприятные условия перехода электронов из p-области в n-область и дырок из n-области в p-область, потоки этих неосновных носителей невелики, так как сравнительно мало общее число неосновных носителей в каждом из полупроводников.
Напряженность контактного электрического поля практически не сказывается на величине потоков неосновных носителей через границу. Независимо от значения напряженности контактного поля любой из неосновных носителей, попавших в область р-n-перехода, будет переправлен этим полем на противоположную сторону от перехода. Величина же каждого из потоков определяется числом неосновных носителей (электронов или дырок), подходящих к переходу, то есть тем, сколько их образуется в непосредственной близости от перехода в процессе тепловой генерации. Именно поэтому сила тока проводимости не зависит от значения контактной разности потенциалов. Толщина слоя полупроводника, прилегающего непосредственно к p-n-переходу и участвующего в создании тока проводимости, определяется диффузионной длиной соответственно Ln для электронов в p-области и Lp для дырок в n-области, то есть средними расстояниями, которые проходят электроны и дырки за время их жизни. Электроны, возникающие благодаря тепловой генерации в объеме p-полупроводника на расстояниях от p-n-перехода, больших, чем Ln, и дырки, возникающие в n-полупроводнике на расстояниях от p-n-перехода, больших, чем Lp, участия в образовании тока проводимости не принимают, так как успевают прорекомбинировать, не дойдя до области p-n-перехода. Диффузионная длина обычно невелика и, например, для германия равна по порядку величины 10-2 см.
Так как сила тока, создаваемого диффузионными потоками основных носителей, зависит от значения потенциального барьера φ0 = eUk, а сила тока проводимости, обусловленного потоками неосновных носителей, от значения потенциального барьера не зависит и оба эти тока имеют противоположные направления, то общая сила тока через p-n-переход равна нулю лишь при определенном значении потенциального барьера, при котором диффузионный ток равен току проводимости.
Электронно-дырочный переход - запорный слой. Контактное поле выталкивает подвижные носители из области p-n-перехода в глубинные области контактирующих полупроводников, где соответствующие носители являются основными: электроны - в n-полупроводник, а дырки - в p-полупроводник. Такое действие контактного поля не дает возможности подвижным носителям из глубинных областей полупроводников проникать в область p-n-перехода и восполнять дефицит основных носителей в этой области. Оставшиеся после ухода электронов нескомпенсированные и жестко связанные с кристаллической решеткой ионы доноров создают положительный объемный заряд в области n-полупроводника, прилегающей к границе контакта, а ушедшие через контакт дырки оставляют в p-области такой же по модулю, но отрицательный заряд нескомпенсированных ионизованных акцепторов. Именно эти неподвижные заряды и создают контактное поле и контактную разность потенциалов.
Уход основной массы подвижных носителей из приконтактных областей и невозможность прихода в эти области новых подвижных носителей приводят к резкому возрастанию сопротивления p-n-перехода по отношению к остальному объему полупроводника. Поэтому область p-n-перехода всегда представляет собой запорный слой.
Толщины обедненных слоев (dn - со стороны n-полупроводника и dp - со стороны p-полупроводника) зависят от степени легированности каждой из контактирующих областей. В случае симметричного p-n-перехода (при ND = NA) толщины dn и dp равны между собой (см. рис. 64, г). Если же p-n-переход несимметричен, то dn ≠ dp. Например, при ND > NA толщина dn обедненного слоя со стороны n-полупроводника меньше толщины dp обедненного слоя со стороны дырочного полупроводника (рис. 66, а). Объясняется это тем, что в более легированном полупроводнике каждый монослой содержит большее число примесных центров и, следовательно, больше подвижных носителей, чем моноатомный слой менее легированного полупроводника. В этом случае говорят, что p-n-переход проникает больше в слаболегированную (более высокоомную) область полупроводника. Если же ND >> NA, то p-n-переход практически полностью локализуется в высокоомной p-области, захватывая только очень тонкий, прилегающий непосредственно к границе контакта слой высоколегированного полупроводника n-типа (рис. 66, б).

Рис. 66
Общая толщина p-n-перехода очень невелика. Например, при средней степени легированности p- и n-областей в кристалле германия толщина перехода составляет величину порядка 1 мкм.
|
ПОИСК:
|