
Дополнение. О. Крохин, Ю. Попов. Полупроводниковые лазеры
1. Условия инверсной населенности в полупроводниках
Применение полупроводников в качестве рабочих материалов для лазеров привлекло к себе внимание в первую очередь возможностью осуществления непосредственного преобразования энергии электрического тока в энергию когерентного излучения. Полупроводники обладают рядом характерных свойств, среди которых от люминесцентных кристаллов их отличает электропроводность, а от газовых систем - весьма широкие линии излучения и возможность создания высокой концентрации активных частиц. Эти свойства полупроводников дают полупроводниковым лазерам ряд особенностей, главной из которых является высокий к. п. д. полупроводникового лазера, который может быть близок к 100%. Энергетический спектр полупроводника, обусловленный электронными состояниями, схематически изображен на фиг. I. В идеальном кристалле он представляет собой широкие полосы разрешенных состояний электронов: зону проводимости 1 и валентную зону 5, разделенные зоной запрещенных энергий 6. Энергетические состояния электронов в зоне проводимости и валентной зоне образуют практически непрерывный спектр собственных значений энергии Е(р), зависящей от импульса электрона*. В неидеальном кристалле возникают уровни энергии 2, 3, 4, связанные с наличием тех или иных нарушений кристаллической структуры (примеси, вакансии, дислокации и т. д.). Как правило, эти состояния локализуются вблизи соответствующего центра в отличие от состояний в разрешенных зонах, принадлежащих всему кристаллу в целом.
* (В случае периодических структур, каковыми являются кристаллы, более правильно говорить не об импульсе, а о квазиимпульсе, величина которого ограничена предельными значениями порядка ±πћ/a, где a - постоянная решетки.)

Фиг. I. Энергетические уровни полупроводника. 1 - зона проводимости; 2 - уровни доноров; 3 - глубокие уровни; 4 - уровни акцепторов; 5 - валентная зона; 6 - запрещенная зона
В идеальном полупроводнике при температуре абсолютного нуля валентная зона полностью занята электронами, а зона проводимости полностью свободна. В этом случае полупроводник не может проводить электрический ток и является изолятором. При температурах выше 0°К вследствие теплового возбуждения часть валентных электронов переходит в зону проводимости, в результате чего электрический ток может течь как за счет электронов в зоне проводимости, так и за счет свободных мест, образовавшихся в валентной зоне. В последнем случае обычно в рассмотрение вводят понятие "дырка", что соответствует незанятому электроном состоянию в валентной зоне. Дырка полностью эквивалентна частице с положительным зарядом и массой. Следует заметить, что электроны и дырки в кристалле имеют массу, отличную от массы свободного электрона и называемую эффективной массой. В идеальном полупроводнике число электронов в зоне проводимости в точности равно числу дырок в валентной зоне. Однако в реальном кристалле число носителей тока определяется в основном наличием примесей, которые можно разбить условно на следующие три группы:
- примеси, уровни энергии которых, как правило, расположены близко к зоне проводимости 2, эти примеси легко отдают электроны в зону проводимости (доноры);
- примеси, уровни энергии которых обычно расположены близко к валентной зоне 4, эти примеси легко захватывают электроны из валентной зоны, оставляя там дырки (акцепторы);
- примеси, уровни энергии которых лежат глубоко в запрещенной зоне 3.
Для получения состояний с инверсной населенностью в полупроводниках могут быть использованы различные переходы электронов: зона - зона, зона - примесь и переходы между уровнями примеси.
При межзонных переходах следует различать два основных случая, определяемых структурой зон полупроводника: прямой переход, т. е. переход без изменения импульса электрона, и непрямой переход, при котором изменение импульса электрона компенсируется импульсом испускаемого или поглощаемого фонона.
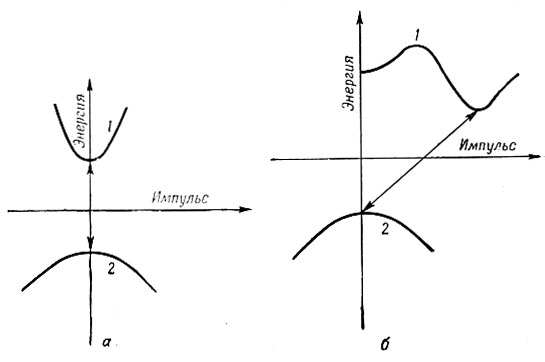
Фиг. II. Зависимость энергии носителей тока от импульса в полупроводниках. а - экстремальные значения энергии соответствуют одному значению импульса; б - экстремальные значения энергии соответствуют разным значениям импульса. 1 - зона проводимости; 2 - валентная зона
На фиг. II схематически изображена зависимость энергии электрона от импульса для зоны проводимости 1 и валентной зоны 2. Согласно закону сохранения импульса, при испускании или поглощении фотона должно выполняться равенство

где  - начальный и конечный импульсы электрона, k - импульс фотона. Величина импульса фотона равна
- начальный и конечный импульсы электрона, k - импульс фотона. Величина импульса фотона равна  где
где  - энергия кванта, c - скорость света, Δ - ширина запрещенной зоны. Отсюда следует, что для полупроводников, для которых
- энергия кванта, c - скорость света, Δ - ширина запрещенной зоны. Отсюда следует, что для полупроводников, для которых  величина k очень мала, т. е. меньше предельного импульса
величина k очень мала, т. е. меньше предельного импульса  на величину
на величину  где λ - длина волны излучения. Таким образом, переход с испусканием или поглощением фотона на диаграмме состояний фиг. II,a изображается вертикальной стрелкой и называется прямым переходом. Из фиг. II, а видно, что поглощению кванта минимальной энергии соответствует переход из максимума валентной зоны в минимум зоны проводимости. В этом случае прямой переход возможен только тогда, когда эти экстремальные значения энергии соответствуют одному и тому же значению импульса. То же относится и к процессу испускания фотона. В том случае, когда экстремальные значения энергии в зоне проводимости и валентной зоне соответствуют разным значениям импульса электрона (фиг. II, б), для выполнения закона сохранения импульса при переходе электрона необходимо испускание (или поглощение) фонона - кванта колебаний решетки кристалла, который практически полностью компенсирует разность импульсов конечного и начального состояний. При этом энергия фонона оказывается меньше энергии фотона. Это, конечно, справедливо, если переход осуществляется между экстремальными точками. Такой переход называется непрямым переходом, и закон сохранения импульса в этом случае имеет вид
где λ - длина волны излучения. Таким образом, переход с испусканием или поглощением фотона на диаграмме состояний фиг. II,a изображается вертикальной стрелкой и называется прямым переходом. Из фиг. II, а видно, что поглощению кванта минимальной энергии соответствует переход из максимума валентной зоны в минимум зоны проводимости. В этом случае прямой переход возможен только тогда, когда эти экстремальные значения энергии соответствуют одному и тому же значению импульса. То же относится и к процессу испускания фотона. В том случае, когда экстремальные значения энергии в зоне проводимости и валентной зоне соответствуют разным значениям импульса электрона (фиг. II, б), для выполнения закона сохранения импульса при переходе электрона необходимо испускание (или поглощение) фонона - кванта колебаний решетки кристалла, который практически полностью компенсирует разность импульсов конечного и начального состояний. При этом энергия фонона оказывается меньше энергии фотона. Это, конечно, справедливо, если переход осуществляется между экстремальными точками. Такой переход называется непрямым переходом, и закон сохранения импульса в этом случае имеет вид

где q - импульс фонона. Для получения состояния с инверсной населенностью в полупроводниках необходимо создание неравновесной концентрации электронов и дырок. Обычно электроны и дырки вследствие сильного взаимодействия с колебаниями решетки даже при неравновесных концентрациях характеризуются фермиевской функцией распределения по энергиям Е с температурой решетки Т:

где μ - уровень Ферми (если концентрация  равновесная) или квазиуровень Ферми (если концентрация n неравновесная), определяемый из условия нормировки
равновесная) или квазиуровень Ферми (если концентрация n неравновесная), определяемый из условия нормировки


- плотность состояний в единичном интервале энергии,

Для определения условия инверсной населенности необходимо потребовать, чтобы суммарное поглощение в данном переходе было отрицательным. Опуская спонтанное излучение, для прямых переходов имеем

Здесь в силу принципа детального равновесия вероятность прямого и обратного процессов принята одинаковой и равной  - функции распределения электронов в зоне проводимости и валентной зоне;
- функции распределения электронов в зоне проводимости и валентной зоне;  - число фотонов в заданном состоянии. Из (Д6) следует, что
- число фотонов в заданном состоянии. Из (Д6) следует, что  т. е.
т. е.

Условие (Д7) является основным условием инверсной населенности при прямых межзонных переходах в полупроводниках и показывает, что в этом случае электроны или (и) дырки должны быть вырождены.
В случаях непрямых переходов представляет интерес процесс одновременного испускания фотона и фонона. При этом процессе излучается наиболее длинноволновый фотон, энергия ћω которого равна начальной энергии электронно-дырочной пары (порядка  минус энергия фонона
минус энергия фонона  , определяемая заданным значением импульса
, определяемая заданным значением импульса  При очень низких температурах
При очень низких температурах  число фононов в кристалле будет мало и обратный процесс, приводящий к поглощению фотона, будет подавлен, в то время как прямой процесс будет идти за счет спонтанного испускания фононов. В этом случае условие инверсии получается из неравенства
число фононов в кристалле будет мало и обратный процесс, приводящий к поглощению фотона, будет подавлен, в то время как прямой процесс будет идти за счет спонтанного испускания фононов. В этом случае условие инверсии получается из неравенства

где  - вероятность перехода, φ - число фононов в заданном состоянии,
- вероятность перехода, φ - число фононов в заданном состоянии,

Из (Д8) получаем

что эквивалентно неравенству

Условие (Д11) является условием инверсной населенности в случае непрямых межзонных переходов. Из (Д11) видно, что в случае, если  , вырождения носителей тока не требуется; в противоположном случае непрямые переходы не дают преимущества по сравнению с прямыми. При
, вырождения носителей тока не требуется; в противоположном случае непрямые переходы не дают преимущества по сравнению с прямыми. При  условие инверсной населенности можно переписать в виде
условие инверсной населенности можно переписать в виде

где n и p - концентрации электронов и дырок


- эффективные массы электрона и дырки.
Интересна возможность непрямого перехода из экситонных состояний. В экситонном состоянии электрон и дырка связаны между собой подобно водородному атому с энергией связи

где  - приведенная масса, ε - диэлектрическая проницаемость. Это обстоятельство приводит к увеличению вероятности перехода. Концентрацию η экситонов можно выразить через концентрацию свободных (невырожденных) электронов и дырок, предполагая, что между ними имеется термодинамическое равновесие,
- приведенная масса, ε - диэлектрическая проницаемость. Это обстоятельство приводит к увеличению вероятности перехода. Концентрацию η экситонов можно выразить через концентрацию свободных (невырожденных) электронов и дырок, предполагая, что между ними имеется термодинамическое равновесие,

где 
 - масса экситона. Условие инверсной населенности при переходе из экситонных состояний имеет вид
- масса экситона. Условие инверсной населенности при переходе из экситонных состояний имеет вид

где  - функция распределения экситонов, что с учетом (Д13) эквивалентно
- функция распределения экситонов, что с учетом (Д13) эквивалентно

Как уже было замечено ранее, состояние с инверсной населенностью возможно получить также в переходах зона - примесь и между уровнями примеси. В первом случае следует, вообще говоря, различать два варианта: переход носителей из одной зоны на уровни примеси, расположенные вблизи края другой зоны, и переход на уровни, расположенные вблизи той же зоны.
В первом варианте вследствие быстрой релаксации носителей между примесью и близко расположенной к уровню примеси зоной заполнение уровня примеси будет определяться квазиуровнем Ферми носителей тока в этой зоне, и условие инверсной населенности примет вид

где  - энергия связи носителя на примеси.
- энергия связи носителя на примеси.
Во втором варианте, как и в случае переходов между уровнями примеси, условие инверсной населенности записывается, как в случае обычной двухуровневой квантовой системы (см. § 6).
Для усиления электромагнитной волны полупроводником необходимо, чтобы индуцированное усиление в переходе с инверсной населенностью превышало поглощение в результате всевозможных других процессов (поглощение примесями, свободными носителями и др.). В режиме генерации необходимо также выполнение условия самовозбуждения, которое зависит от потерь энергии излучения в объемном резонаторе. Для решения этих задач необходимо вычислить коэффициент усиления в переходе с инверсной населенностью. Для прямых межзонных переходов коэффициент усиления можно получить, записав в (Д6) явное выражение для вероятности перехода [1] и просуммировав по начальному и конечному состояниям с учетом законов сохранения.
В этом случае коэффициент усиления α1 равен [2]

где  - энергия электрона в зоне проводимости, M - матричный элемент. При непрямых переходах коэффициент усиления может быть получен из (Д8) суммированием по уровням валентной зоны и зоны проводимости с учетом закона сохранения энергии
- энергия электрона в зоне проводимости, M - матричный элемент. При непрямых переходах коэффициент усиления может быть получен из (Д8) суммированием по уровням валентной зоны и зоны проводимости с учетом закона сохранения энергии

Выбирая за начало отсчета энергии край зоны проводимости, коэффициент усиления при непрямых переходах α2 можно записать в виде

где плотность СОСТОЯНИЙ В зоне проводимости  и в валентной зоне
и в валентной зоне  дается формулой (Д5). Первое слагаемое в (Д19) соответствует поглощению, второе - усилению. В том случае, когда носители тока не вырождены, можно положить
дается формулой (Д5). Первое слагаемое в (Д19) соответствует поглощению, второе - усилению. В том случае, когда носители тока не вырождены, можно положить 
 и
и  тогда вычисление интегралов в (Д19) дает
тогда вычисление интегралов в (Д19) дает

где представлено явное выражение для φ.
Из (Д20) видно, что при  первый член, соответствующий поглощению, становится малым.
первый член, соответствующий поглощению, становится малым.
Поглощение излучения в полупроводнике, как уже было отмечено ранее, может происходить на примесях, дефектах и свободных носителях тока. Поглощение решеткой становится существенным в дальней инфракрасной области спектра.
Коэффициент поглощения на примесях и дефектах k1 может быть вычислен, если известно сечение поглощения фотона א, и выражается элементарной формулой

где N - плотность поглощающих центров. Поглощение на свободных носителях тока может происходить только в результате взаимодействия с решеткой, поскольку, как хорошо известно, свободная заряженная частица не может поглощать электромагнитную волну. Этот процесс может быть описан посредством диэлектрической проницаемости ε, мнимая часть корня квадратного из которой дает величину поглощения k2:

где 
Согласно работе [1], диэлектрическая проницаемость ε равна

где  - частоты соударений электронов и дырок в кристалле, определяющие проводимость полупроводника
- частоты соударений электронов и дырок в кристалле, определяющие проводимость полупроводника

а  - диэлектрическая постоянная без учета свободных носителей тока. В случае, когда
- диэлектрическая постоянная без учета свободных носителей тока. В случае, когда  имеет место соотношение
имеет место соотношение

Если частоты соударений электронов и дырок с решеткой близки, т. е.  то коэффициент поглощения можно записать в виде
то коэффициент поглощения можно записать в виде

Иногда бывает удобно вводить сечения поглощения  фотона свободными носителями тока. Согласно (Д22)-(Д25),
фотона свободными носителями тока. Согласно (Д22)-(Д25),

и

Как хорошо известно, прямые переходы в полупроводниках характеризуются сравнительно большой вероятностью перехода, превышающей вероятность поглощения на свободных носителях тока. Это обеспечивает возможность получения отрицательного коэффициента поглощения в прямых межзонных переходах. Однако в случае непрямых межзонных переходов оба процесса - поглощение на свободных носителях тока и непрямой переход - сопровождаются испусканием или поглощением фонона, что приводит к тому, что вероятности этих процессов могут иметь близкие значения. Это обстоятельство затрудняет получение отрицательного поглощения с использованием непрямых межзонных переходов. В этом случае необходим выбор такого полупроводника, который имеет большую вероятность непрямых переходов.
При непрямой рекомбинации экситона вероятность излучения w может быть вычислена из вероятности перехода свободных носителей тока  В этом случае имеем [3]
В этом случае имеем [3]

где R - радиус экситона, равный по порядку величины 
 - боровский радиус. Отношение интенсивности излучения, возникающего в результате непрямой рекомбинации экситонов, к интенсивности при непрямых переходах равно
- боровский радиус. Отношение интенсивности излучения, возникающего в результате непрямой рекомбинации экситонов, к интенсивности при непрямых переходах равно

с учетом (Д13) и (Д28) это отношение имеет вид

Вследствие того, что в выражение (ДЗО) входит малый множитель  это отношение может быть большим при низких температурах, что облегчает получение отрицательного поглощения при использовании переходов из экситонных состояний.
это отношение может быть большим при низких температурах, что облегчает получение отрицательного поглощения при использовании переходов из экситонных состояний.
|
ПОИСК:
|